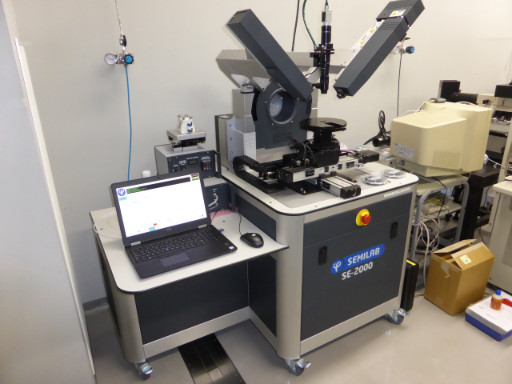
| 名称等 | 分光エリプソメータ | 設備分類 | 計測技術(電磁光音など) |
|---|---|---|---|
| 製造元 | 日本セミラボ株式会社 | 仕様・品質等 | SE2000 |
| 用途等 | 光学デバイス作成において、光学薄膜の光学定数および膜厚を測定する装置。 |
||
| 詳細仕様 | ・測定対象物質:金属、絶縁体、半導体
○反射率測定モジュール詳細仕様 <斜入射反射率> |
使用料 | 1,130(円/時間) | 導入年度 | 平成28年度 |
| 設置場所 | 高度技術研究館 1F:精密測定室407 | 主担当者名 | 山根 治起 |
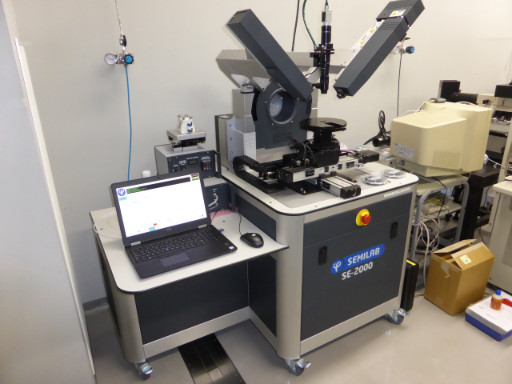
| 名称等 | 分光エリプソメータ | 設備分類 | 計測技術(電磁光音など) |
|---|---|---|---|
| 製造元 | 日本セミラボ株式会社 | 仕様・品質等 | SE2000 |
| 用途等 | 光学デバイス作成において、光学薄膜の光学定数および膜厚を測定する装置。 |
||
| 詳細仕様 | ・測定対象物質:金属、絶縁体、半導体
○反射率測定モジュール詳細仕様 <斜入射反射率> |
使用料 | 1,130(円/時間) | 導入年度 | 平成28年度 |
| 設置場所 | 高度技術研究館 1F:精密測定室407 | 主担当者名 | 山根 治起 |